現如今,針對封裝產品的失效分析方式多種多樣。以下簡單介紹幾種分析方式。
超聲波掃描電子顯微鏡。
一種無損檢測,通過超聲波在不同介質中的傳播速度、反射率的差異性,來檢測樣品內部是否存在分層現象。

引腳、支架與塑封體之間有分層現象
X光檢測。
一種無損檢測,可方便有效的觀察BGA、IC、二極管、三極管等封裝產品的內部結構,可快捷的觀察到失效現象。
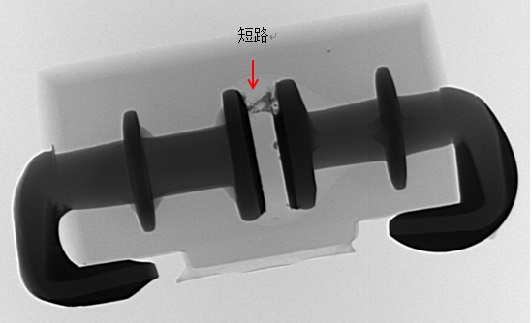
X-ray CT掃描。
也是一種無損檢測,輔助X光檢測,三維立體更形象的觀察失效現象。

Cross Section
一種破壞性檢測。通過灌封、研磨、拋光處理后,用顯微鏡對封裝產品內部指定部位的截面位置進行觀察分析。
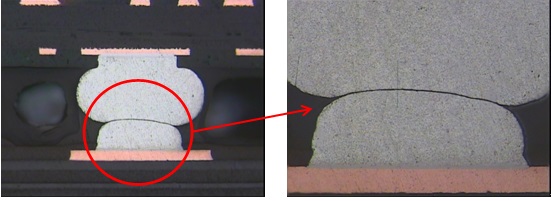
封裝產品開封
也是一種破壞性檢測。通過降產品的封裝材料、塑封體溶解之后,用顯微鏡對產品內部線路、晶元等進行觀察分析,是BGA、IC產品的常用檢測手段。



















