對封裝的半導體器件進行開封,可以讓我們更直觀的觀察晶元表面以及連接外部各Pin腳的打線情況,對于IC、LED等封裝產品的失效分析來說是非常有效的手段之一,因IC等半導體封裝用樹脂中多為含有莉香等填料的環氧樹脂,一般采用發煙硝酸等藥水對樹脂進行溶解。但是,近幾年來,作為連接半導體TIP和引線框的引線之材質,不僅僅是Au(金),Cu和Ag線也逐漸被使用。
因此,用傳統的藥水來開封,往往會導致引線也被溶解的情況發生,本文僅對藥水開封時可能發生的情況,以及晶元表面可觀察到的不良現象進行舉例,并對實際實驗可能發生的情況,提供預防措施。
1、 開封后晶元表面可發現的不良現象
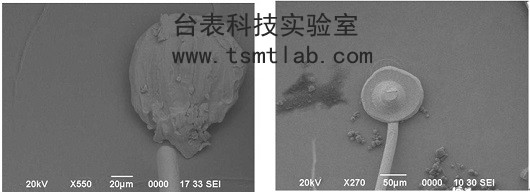
不良位置 OK位置
此為開封后發現打點處打線斷裂,是較為常見的不良現象之一。
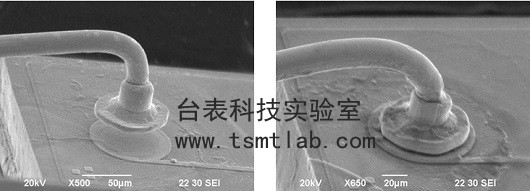
不良位置 OK位置
此為開封后發現晶元表面打點起翹,對應的實際現象可能為產品根據溫度不同偶爾會失效,或是直接失效。
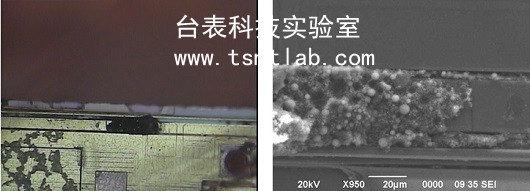
此為晶元表面發現EOS,多為大電流導致,表面形成類似黑色黏著物
2、 開封過程中我們實際可能發生的情況。

人為應力
在開封過程中夾取樣品的時候由于操作不當,夾取樣品的位置錯誤,令鑷子碰觸晶元表面,使得打線或晶元表面,晶元表面線路受到硬力,從而出現打線、晶元表面線路被壓扁或者斷裂,晶元表面破損等現象。

在對IC進行自動開蓋機開蓋或手動開蓋時應先將IC粘著在銅板上,一個是在夾取樣品時可以直接夾取銅板,而不是直接接觸晶元,第二這樣可以一定程度上保護打線不會因外部應力作用而斷裂
近幾年來,作為連接半導體TIP和引線框的引線之材質,不僅僅是Au(金),Cu和Ag線也逐漸被使用。因此,用傳統的藥水來開封,往往會導致引線也被溶解的情況發生。對于這類事件,我們需要加快開封速度同時在開封前先使用X-ray進行初步的觀察,了解晶元結構后再進行開封。并且開封前應將此類元器件直接焊接在基板上可以有效的防止內部打線的斷裂。


















