本文轉(zhuǎn)載:中國(guó)SMT在線
以下是PCB焊盤(pán)的分析報(bào)告:
一、樣品描述
所送檢的PCBA樣品經(jīng)電性能測(cè)試發(fā)現(xiàn)其BGA部位可能有焊接不良(懷疑虛焊)存在,現(xiàn)需分析該問(wèn)題是該P(yáng)CBA在SMT制程中造成或是PCB的(即上錫不良)原因。一件PCBA樣品與所用的3件PCB樣品。
二、分 析 過(guò) 程
1.顯微分析
將PCBA上的BGA部分切下,用環(huán)氧樹(shù)脂鑲嵌、刨磨、拋光、腐蝕制作BGA焊點(diǎn)的金相剖面或截面,然后用Nikon OPTIPHOT金相顯微鏡與LEICA MZ6立體顯微鏡進(jìn)行觀察分析,發(fā)現(xiàn)在第一排的第四焊點(diǎn)存在缺陷,錫球與焊盤(pán)間有明顯的分離現(xiàn)象(圖1),其他焊點(diǎn)未檢查到類似情況。
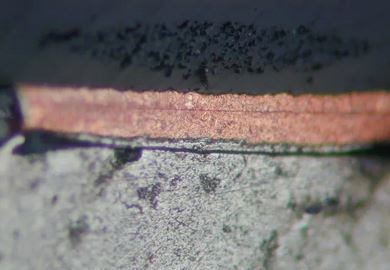
圖1 BGA焊點(diǎn)(第一排第4個(gè))切片截面顯微鏡照片(1)
2.PCB焊盤(pán)的可焊性分析

圖2 BGA焊點(diǎn)缺陷部位放大的顯微鏡照片(2)
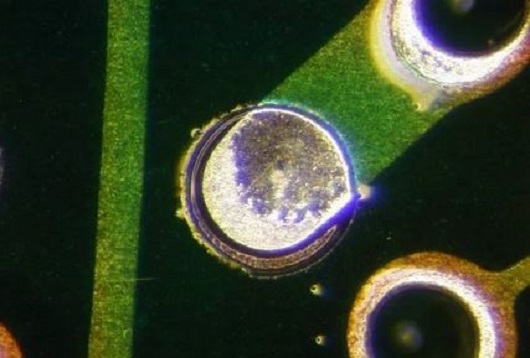
圖3 PCB上的BGA焊接部位的潤(rùn)濕不良的焊盤(pán)(1)
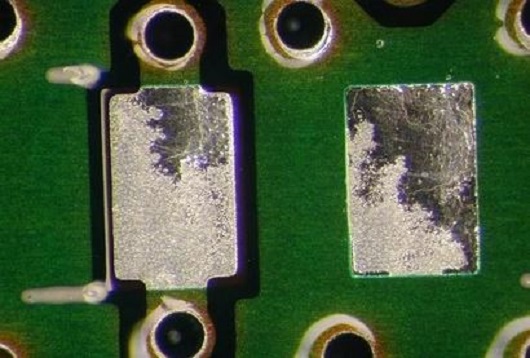
圖4 PCB上的潤(rùn)濕不良的焊盤(pán)(2)
3.PCB表面狀態(tài)分析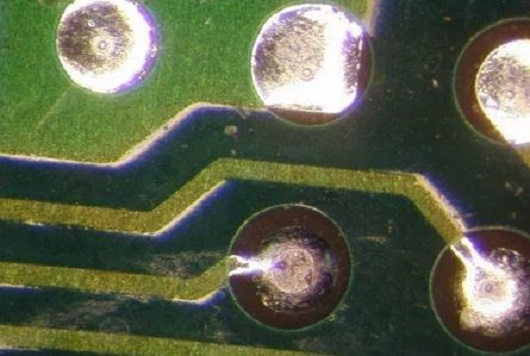
圖5 在PCB上檢測(cè)到的一個(gè)不良焊盤(pán)的外觀
4.SEM以及EDX分析
圖6 不良焊點(diǎn)截面的外觀SEM分析照片

圖7 SEM照片中A部位的化學(xué)(元素)組成分析結(jié)果
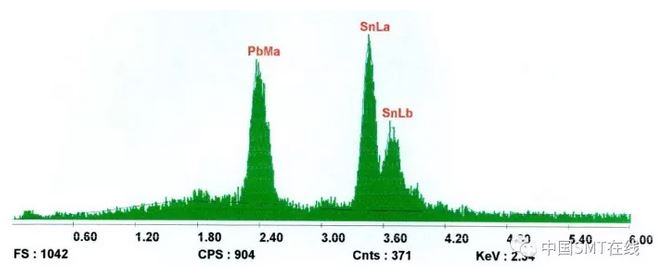
圖8 SEM照片中B部位的化學(xué)(元素)組成分析結(jié)果
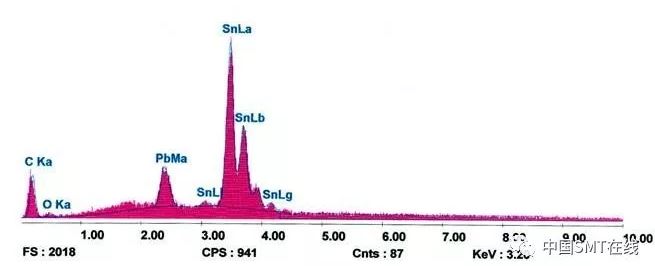
圖9 圖5中不良焊盤(pán)的表面的化學(xué)(元素)組成分析結(jié)果
5.焊錫膏的潤(rùn)濕性分析
三、結(jié) 論
經(jīng)過(guò)以上分析,可以得出這樣的結(jié)論:
送PCBA樣品的BGA部位的第一排第4焊點(diǎn)存在不良缺陷,錫球焊點(diǎn)與焊盤(pán)間有明顯開(kāi)路。
造成開(kāi)路的原因?yàn)椋涸揚(yáng)CB的焊盤(pán)潤(rùn)濕性(可焊性)不良,焊盤(pán)表面存在不明有機(jī)物,該有機(jī)物絕緣且阻焊,使BGA焊料球無(wú)法與焊盤(pán)在焊接時(shí)形成金屬化層。


















